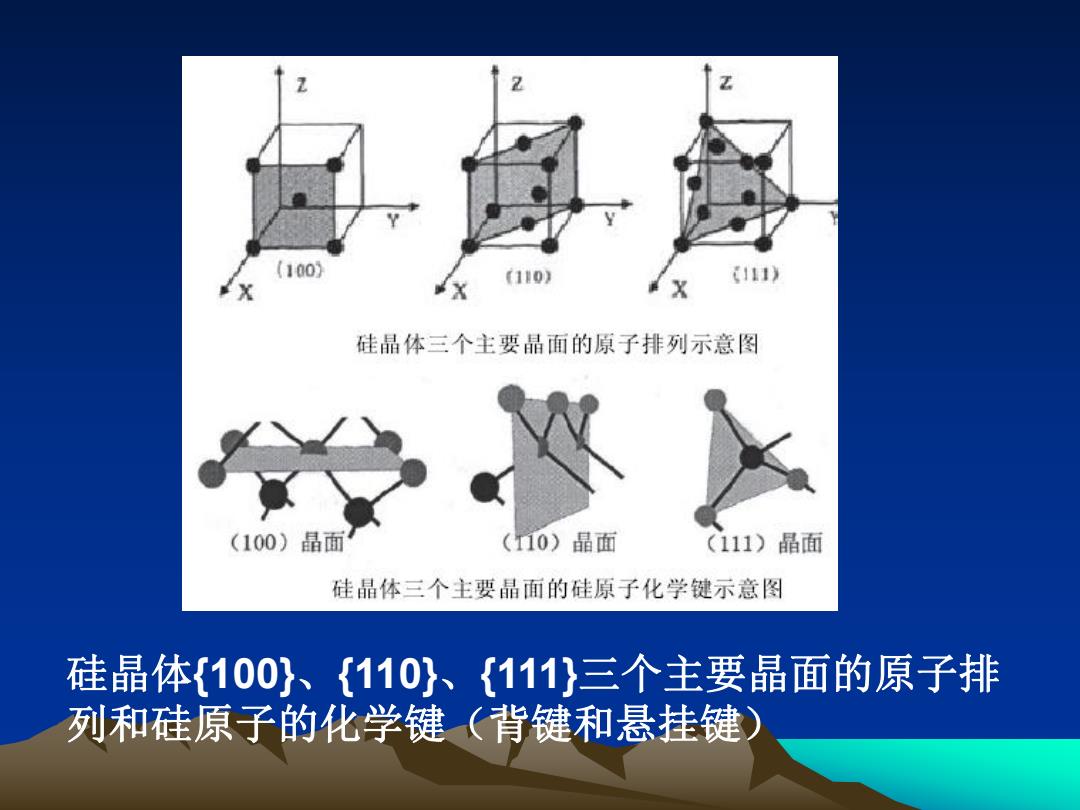
(100】 (110) 111) 硅晶体三个主要晶面的原子排列示意图 (100) 晶面 (110)晶面 (111)晶面 硅晶体三个主要晶面的硅原子化学键示意图 硅晶体100}、110}、111}三个主要晶面的原子排 列和硅原子的化学键《背键和悬挂键
硅晶体{100}、{110}、{111}三个主要晶面的原子排 列和硅原子的化学键(背键和悬挂键)

1、硅晶体中{111}晶面的硅原子密度最大,而且 {111}晶面上的一个硅原子与次表面的三个硅原子 形成背键,还有一个悬挂键 。 2、{100}晶面的硅原子密度次大,其上的一个硅原 子与次表面上的两个硅原子形成两个背键,还有 两个悬挂键 3、{110}晶面的原子密度最小,其上的一个硅原子 与次表面上的一个硅原子形成一个背键,同时与 表面原子形成两个背键,还有一个悬挂键
1、硅晶体中{111}晶面的硅原子密度最大,而且 {111}晶面上的一个硅原子与次表面的三个硅原子 形成背键,还有一个悬挂键。 2、{100}晶面的硅原子密度次大,其上的一个硅原 子与次表面上的两个硅原子形成两个背键,还有 两个悬挂键 3、{110}晶面的原子密度最小,其上的一个硅原子 与次表面上的一个硅原子形成一个背键,同时与 表面原子形成两个背键,还有一个悬挂键

<100 钻蚀 各向同性湿法腐蚀 各向异性湿法腐蚀 各向异性湿法腐蚀是指腐蚀剂对某一晶向的腐蚀速 率高于其他方向的腐蚀速率。腐蚀结果的形貌由腐 蚀速率最慢的晶面决定。基于这种腐蚀特性,可在 硅衬底上加工出各种各样的微结构。各向异性湿法 腐蚀所用的腐蚀液通常对硅的腐蚀速率都比较小, 般在每分钟1m左右
各向异性湿法腐蚀是指腐蚀剂对某一晶向的腐蚀速 率高于其他方向的腐蚀速率。腐蚀结果的形貌由腐 蚀速率最慢的晶面决定。基于这种腐蚀特性,可在 硅衬底上加工出各种各样的微结构。各向异性湿法 腐蚀所用的腐蚀液通常对硅的腐蚀速率都比较小, 一般在每分钟 1µm 左右

常用的化学腐蚀试剂一般分为两类,一类是无机腐 蚀剂,包括氢氧化钾(KOH)、氢氧化钠(NaOH )、氢氧化铵(NH4OH)等,另一类是有机腐蚀 剂,包括EDP(乙二胺邻苯二酚)、四甲基氢氧化 铵(简称TMAH(CH3)4OH)和联胺等 在选择腐蚀剂时,通常需要考虑以下几个因素: (1)操作的方便性; (2) 无毒性; (3)腐蚀速率适当; (4) 能得到希望的腐蚀底面拓扑结构; (5) 具有IC兼容性; (6) 能实现腐蚀自停止; (7) 和其他材料具有一定的腐蚀选择比; (8)掩膜材料和厚度容易得到
• 常用的化学腐蚀试剂一般分为两类,一类是无机腐 蚀剂,包括氢氧化钾(KOH)、氢氧化钠(NaOH )、氢氧化铵(NH4OH)等,另一类是有机腐蚀 剂,包括 EDP(乙二胺邻苯二酚)、四甲基氢氧化 铵(简称 TMAH[(CH3)4OH])和联胺等。 在选择腐蚀剂时,通常需要考虑以下几个因素: (1)操作的方便性; (2)无毒性; (3)腐蚀速率适当; (4)能得到希望的腐蚀底面拓扑结构; (5)具有 IC 兼容性; (6)能实现腐蚀自停止; (7)和其他材料具有一定的腐蚀选择比; (8)掩膜材料和厚度容易得到

{110}硅片上的111}面 {110}晶面是硅片上用途最广泛的晶面之一。由于 <110>晶向的硅片上存在若干与硅片表面垂直的{111} 面,因此,通过湿法腐蚀得到高深宽比结构是{110}硅 的主要用途之一。 01) 34.5 11D (111) (T11) afD 70.53 (ID
{110}晶面是硅片上用途最广泛的晶面之一。由于 <110>晶向的硅片上存在若干与硅片表面垂直的{111} 面,因此,通过湿法腐蚀得到高深宽比结构是{110}硅 的主要用途之一